 搜索
搜索
“正大期货"

扫码下载APP
作者: 正大期货 来源:https://www.xasswkj.com/ 阅读次数:次 2023-08-07 09:05 【字体: 大 中 小】
2017 年 11 月21日,时任台积电董事长的张忠谋在台下静静拍手,这一天的主角,不是声名赫赫的他,而是此前静静无名的余振华。
接过奖项的他,指了指着一旁记者手中的iPhone说:“这个就有InFO(整合扇出型封装),从iPhone 7就开端了,现在继续在用,iPhone 8、iPhone X,今后其他手机也会开端用这个技能。”

这儿说到的InFO,即先进封装中的一种,正是它让台积电轻松吃下iPhone 7中 A10处理器的悉数订单,把2015年还在代工A9处理器的三星挤出局,一举奠定了台积电的江湖位置。
依靠着InFO,苹果A10处理器在沿袭16nm FinFET 工艺的情况下,仍旧完结了不俗的功用提高,相较于近邻用上三星10nm工艺的骁龙835和Exynos 8890也未差劲多少。
而先进封装这把利器,此刻借由苹果之手,揭开了它奥秘的面纱,向着世人款款而来。
封装,摸着石头过河
苹果与先进封装的故事,或许还得从2007年讲起。
下面这张图是诺基亚N95——一款出售于2007年3月的智能手机的主板,它不只搭载了强悍的双处理器,还有鳞次栉比的模仿芯片,其杂乱程度,并不亚于其时恣意一款高端笔记本电脑。
一同N95还有三块不同的存储芯片,分布在两颗处理器的周围,光是想要澄清这款手机的硬件架构,就需要花费不少力气,修理起来也是件适当费事的工作。
而其他一张主板图相同来自于2007年出售的手机——初代iPhone,仔细观察后,咱们会发现,整个主板的集成度相较于N95更高,各类芯片鳞次栉比地排布在一同,互相间的空地大大缩短。
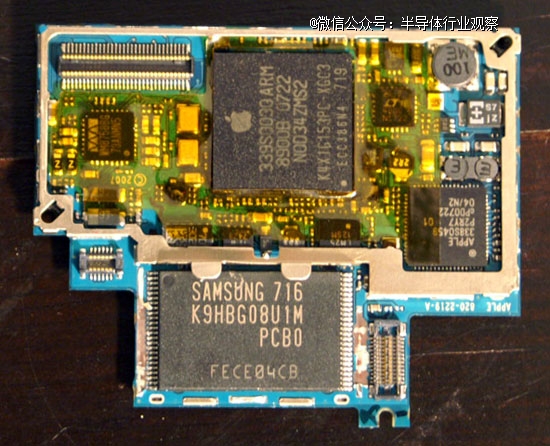
更重要的是,咱们在这个主板上,只能找到处理器与NAND,在一切手机中都能看到的DRAM却没了踪迹,难道说苹果有什么黑科技,能把DRAM丢到副板上?
答案藏在苹果Logo芯片的下方,这颗名为APL0098的SoC,实际上是三星S5L8900的换皮版,它的下方,封装堆叠了两块三星出品的512 MB SDRAM,是的没错,苹果在初代iPhone上就选用了层叠式封装 (PoP),将DRAM和SoC集成在了一同。
而这项技能,天然也是出自三星之手,台积电其时也不得不自愧不如,从初代iPhone到iPhone 5s,一切苹果处理器与封装均由三星独自完结,乃至于苹果A4自研芯片的研制,也在适当程度上受到了三星的影响。

有我国台 湾半导体人士点评道,三星是全国际*可量产存储与处理器,也有自家封测厂的半导体厂,由它承制,整个A7处理器可在「一个房顶」下完结,在本钱、整合度具有巨大优势,台积电的确难以在短时间内追赶上。
苹果喜爱PoP封装也不是没有理由的,与传统封装比较,PoP封装占用较少的基板,而较小的尺度与较少的分量反过来又减小了电路板面积,而与DRAM较短的互联能完结更快的数据传输速率,且在制作进程的每个环节都能节省本钱。
iPhone 5s上的先进封装不过是苹果小试牛刀,苹果真实用好这一利器,还要比及2014年的Apple Watch。
在这一年9月的发布会上,苹果的CEO库克在时隔多年后又一次预备了One More Thing,只不过这次主角是智能穿戴,继iPad之后,苹果又推出了Apple Watch这一全新品类。
发布会上,库克也是大吹特吹了一通,尽管Apple Watch并不是市面上最早的智能手表,但库克依然把它视作一款革新性的产品,“它不是缩小版的 iPhone,而是一种'直接经过手腕进行通讯的立异方法,它的功用远不止这些。"库克在舞台上信誓旦旦。
Apple Watch的许多先进功用现在看来现已稀少往常,大部分千元级其他智能手表都可以轻松做到,但它的中心——S1芯片却是其他厂商从未追赶上的。
当拆解组织掀开Apple Watch的屏幕时,映入眼帘的只要一块电池和一颗线性振荡马达,驱动手表的处理器却没了踪迹,直到掀开电池,印着苹果Logo的封装芯片才得以揭晓。
这块印着S1的芯片被牢牢压在了电池和马达下面,而它选用的封装工艺,正是咱们今日津津有味的SiP(System In a Package体系级封装)。
拆解显现,SiP封装真实表现了将整个体系进行封装的精华,在一块26.15 mm x 28.50 mm的主板上,集成了多达14颗左右的中心芯片产品,以及上百个电阻电容等元器件,一切元器件都有各自独立的封装,并严密有序地摆放在主板上,而除了惯性组合传感器外,其他都元器件都封装在一同,整个封装的厚度仅为1.16mm。
26.15 mm x 28.50 mm×1.16mm,传统芯片的巨细,构成了一个体系,其杂乱程度,乃至逾越了当年与它一同出售的iPhone 6主板。

但先进封装的背面,不再是了解的三星操刀,苹果把目光抛向了我国台 湾,晶圆代工固然是这儿家喻户晓的优势,台积电就肩负着代工A8芯片的重担,但封装测验作为半导体中极为重要的一环,我国台 湾也并不比其他国家区域差劲多少。
那S1芯片,背面又是谁在出力呢?据媒体报导,S1的 SiP基板出自景硕与南电之手,而SiP封装及模组代工则由封测大厂日月光独占,三大供货商因苹果走到了一同,一同为初代Apple Watch细巧身躯里注入了强壮的动力。
PoP加SiP,苹果摸着石头过河,在先进封装上踩出了一条归于自己的路。
强强联合,改动国际
眼看着自初代iPhone以来,先进封装越来越吃香,苹果也开端揣摩起了更高档的封装方式,光是三星的PoP现已难以满意苹果的食欲,更薄的封装现已势在必行。
而代工过A8和部分A9芯片的台积电,拿出了一项苹果无法回绝的技能——InFO。
现实上,台积电从2009年就已开端布局封装,其间的带头人是蒋尚义,而担任开发的,便是前文中说到的余振华,他一手缔造了今日在AI中正炽热的CoWoS。
其时张忠谋对先进封装这个方向极为看好,还专门拨了400个研制工程师给余振华,他也不负众望,在三年后顺畅开宣布CoWoS技能,即*代CoWoS技能。
这项2011年发布的技能,首先是被赛灵思的高端 FPGA 选用。其间Si 中介层的*尺度为775mm2 (25 mm x 31 mm),挨近一个掩模版的曝光尺度(26mm x 33mm)(在 ArF 浸入式光刻机的情况下),而FPGA 芯片制作技能是 28 纳米 CMOS 工艺,选用该技能的赛灵思高端FPGA“7V2000T”在“CoWoS_S”中装备了四个FPGA逻辑芯片。
在2014年发布的第二代“CoWoS_S”中,硅中介层扩大到1150mm2,挨近1287mm2,这是1.5分划板的曝光面积,在2015年被赛灵思高端FPGA“XCVU440”选用,其选用20 纳米 CMOS 工艺,装备了三块 FPGA 逻辑芯片。
连续两代的CoWoS,都没有翻起太大的风波,只要赛灵思成为了台积电这项新技能的顾客,这也让开发技能的余振华产生了不坚定,“(如同)或人夸下海口,要了许多资源,做了个没什么用的东西,“他在后续的采访中回想道。
是CoWoS技能还不够好吗?当然不是,理论上运用这项技能的处理器,可以减缩多达70%厚度,关于寸土寸金的半导体来说,这个引诱不可谓不大。
但消除他们想法的,是CoWoS的本钱,有台积电的客户在接洽时表明,这类技能要被承受,价格不能超过每平方毫米1美分,但CoWoS的价格却到达了5倍以上,即使是大公司,不免也会感到肉疼。
为了改动叫好不叫座的局势,台积电的高层决议开发一个每平方毫米1美分的先进封装技能,功用可以比CoWoS略差一些,可是一定要争取到大客户。
这项技能便是首度用在iPhone 7与7Plus的InFO封装,终究成为台积电吃下苹果A10芯片悉数订单的要害之地点。
InFO全称为Integrated Fan-Out,意为集成式扇出型封装,要点为集成和扇出型封装。说到InFO封装,首先要先说一下FOWLP(Fan-Out Wafer Level package)封装。传统的WLP在切开前进行封装,尽管减小了封装尺度,可是使I/O数量受到了约束,为了满意I/O数量增多的需求,FOWLP应运而生。FOWLP运用扇出型技能,经过RDL层,将Die外表的触点扩展到Die的投影面积之外,添加了凸点安置的灵活性以及增多了引脚数量。通常情况下的FOWLP封装的特色为尺度较小,无基板,塑封封装。InFO封装在某些方面与FOWLP具有相同的特色,而一同又在其进步行了开展。
一般来说,Info封装包括三种类型:InFO_oS、InFO_PoP以及InFO_LSI。而台积电给苹果供给的,便是Info_PoP封装,它的全称为Integrated Fan-out Package on Package,是FOWLP与PoP封装的结合体,它将不同类型的芯片在笔直方向上堆叠在一同,基层为FOWLP封装的芯片,上层为 DRAM 等被迫芯片,封装之间经过TIV(Through Info Via)进行电气互联。
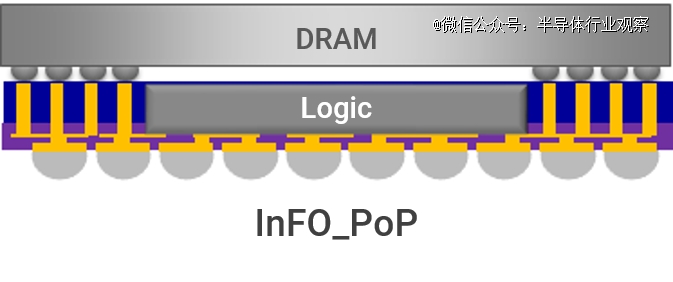
与三星供给的PoP封装比较,InFO_PoP不需要硅中介层,答应多个倒装芯片组件被放置在封装基板上,经过封装衬底互连到互相,不只缩小了芯片面积与厚度,在价格上也更具竞争力,
据一位曾参与苹果订单的封测厂高层主管回想,三星算是大意失荆州,当台积电提出InFO时,封装经历更丰厚的三星,却以为只要将既有的PoP封装略微改进,就可到达苹果要求的厚度水准,而现实明显并非如此。
而InFO技能几经改进,不只在iPhone上沿袭至今,还让Mac产品也受惠于此。
当苹果在2021年推出 20 核的 M1 Ultra 处理器时,它的 UltraFusion 2.5 TB/s 处理器间互连让国际为之注目,而怎么做到这一点,也成为了一切半导体职业人士关怀的问题。
它的背面,便是Info_PoP的迭代版别——Info_LSI技能。
Info_LSI封装全称Integrated Fan-out_Local Silicon Interconnect,此种封装运用硅桥以
及RDL层替代整块硅,到达了功用与本钱的平衡,依据TechInsights的解析,硅桥将两块M1 Max处理器衔接在一同,完结了低电阻、低推迟和高带宽,而M1 Ultra 也是 TechInsights 记载的*个运用 InFO-LSI 技能的设备示例。
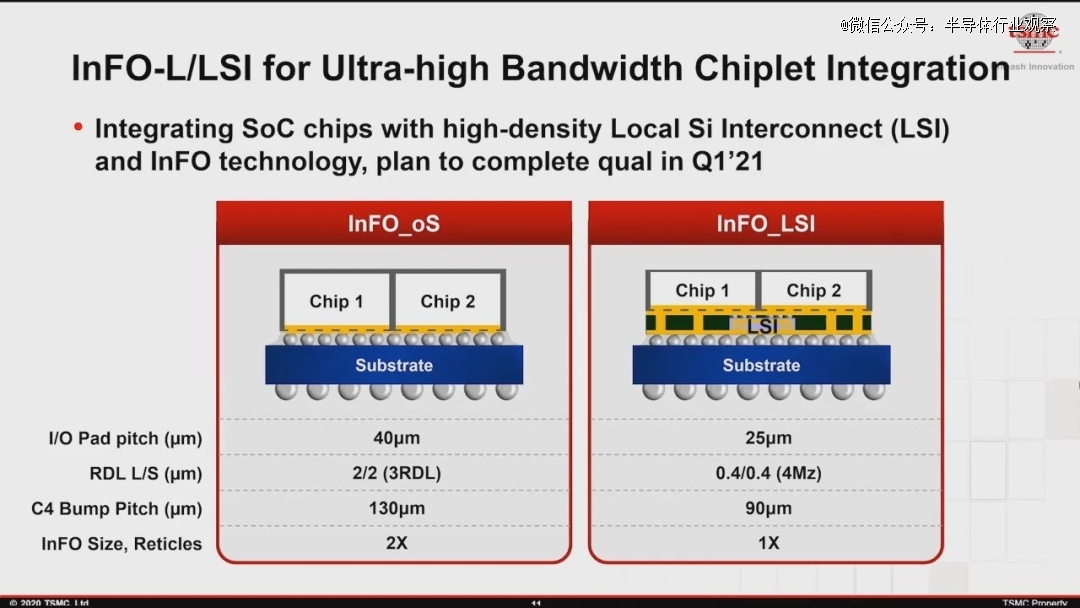
先进封装不只把两颗处理器牢牢地粘合在一同,也在苹果和台积电之间建立起了一座硅桥,两个巨子携手,掀起了一场关于封装的狂风骤雨。
下一块先进封装芯片
关于苹果来说,满意于现有封装技能似乎是彻底不或许的工作,即使是在工艺制程上遥遥*的台积电,也在5nm节点上停留了良久,直到本年才完结了3nm节点的大规模量产,至于更远的GAA和2nm,短期内必定难以快速完结。
而苹果作为电子消费产品发家的一家公司,关于功用也有种超乎一般公司的执着,每年一迭代手机里的处理器,功用也有必要跟着迭代,而重生的自研芯片版Mac,更是需要在英特尔和AMD的压力下,坚持住自己*的功用功耗,而摩尔定律逐步失效的今日,台积电的先进封装就成为了苹果压箱底的法宝。
据台媒报导,苹果正小量试产最新的3D小芯片堆叠技能SoIC(单线集成电路小概括封装),现在规划选用SoIC调配InFO的封装计划,估计用于MacBook,最快2025~2026年推出产品。
SoIC又是什么新技能呢?依据台积电在第二十四届年度技能研讨会中的阐明,SoIC是一种立异的多芯片堆叠技能,是一种晶圆对晶圆(Wafer-on-wafer)的键合(Bonding)技能,这是一种3D IC制程技能,可以让台积电具有直接为客户出产3D IC的才能。
最让人啧啧称奇的是,SoIC技能是选用硅穿孔(TSV)技能,可以到达无凸起的键合结构,可以把许多不同性质的接近芯片整合在一同,当中最要害、最奥秘之处,就在于接合的材料,号称是价值高达十亿美元的秘要材料,因此能直接透过细小的孔隙交流多层的芯片,达到在相同的体积添加多倍以上的功用,简言之,可以继续保持摩尔定律的优势。
台积电赴日本参与VLSI技能及电路研讨会宣布技能论文时,也针对SoIC技能宣布过论文,表明SoIC解决计划将不同尺度、制程技能及材料的裸晶堆叠在一同。相较于传统运用微凸块的三维积体电路解决计划,台积电的SoIC的凸块密度与速度高出数倍,一同大幅削减功耗。此外,SoIC可以运用台积电的InFO或CoWoS的后端先进封装至技能来整合其他芯片,打造强壮的3D×3D体系级解决计划。
有媒体以为,从台积电开始提出的CoWoS技能,到独占苹果代工的InFO技能,下一个让它笑傲于封装职业的,便是SoIC技能。
现在,台积电的SoIC技能现已在竹南六厂(AP6)进入量产,月产能近2000片,预期未来几年将继续翻倍增加,AMD是其首发客户,最新的MI300选用了 SoIC调配CoWoS封装的计划。
根据本钱、规划等要素考虑,苹果大概率会选用SoIC调配InFO的解决计划,或许在M3 Ultra上就能一睹这项技能的实力。
PoP技能带领iPhone杀入智能手机商场,InFO让苹果自研移动芯片走上兴起之路,而SoIC,会让苹果在桌面端芯片上掀起一场新的封装革新吗?
「材料来历:」
一个「小媳妇部分」为何能让台积电打败三星、独吃苹果?——天下杂志
Apple M1 Ultra Advanced Packaging Innovative packaging architecture using Apple’s UltraFusion.——TechInsights
Apple Watch*拆解:主板结构及内部传感器工艺深度剖析——SITRI
免责声明:此消息为 正大期货原创或转自合作媒体,登载此文出于传递更多信息之目的,并不意味着赞同其观点或证实其描述,请自行核实相关内容。文章内容仅供参考,不构成 正大期货投资建议。